在现代半导体产业的精密舞台上,玻璃正悄然扮演着越来越关键的角色。它不再仅仅是晶圆厂中的背景元素,而是成为了推动技术创新的重要材料。
硼硅酸盐载体以其超平整的表面,在硅晶圆的背面减薄过程中发挥着不可或缺的支撑作用。同时,无钠薄片被用作MEMS器件的密封盖帽,确保器件的稳定性和可靠性。而低热膨胀系数(CTE)玻璃,更是凭借其独特的性能,成为了众多晶圆级扇出工艺的首选基板。
随着技术的不断发展,玻璃正逐渐从消耗品转变为封装技术的核心。它不仅作为核心基板承载着芯片,还作为中介层连接着各个芯片,甚至在亚太赫兹信号处理和光子引导方面发挥着重要作用。其优异的性能和广泛的应用前景,让玻璃成为了半导体封装领域的新宠。
这一转变的背后,是人工智能和高性能计算设备对带宽和功率密度的持续追求。随着单个训练加速器对高速I/O引脚和供电网络的需求不断增长,传统的有机层压板已经难以满足要求。硅中介层虽然可以提供更精细的布线,但其价格和面板尺寸的限制使其难以广泛应用。而玻璃,则巧妙地介于这两者之间,成为了理想的解决方案。
玻璃的热膨胀系数可以定制以匹配硅,其损耗角正切在40 GHz频率下比硅低一个数量级。液晶行业的大面板加工技术使得单片玻璃的边长可以达到半米,而随着良率的提高,玻璃的成本也趋向于高端有机材料。这些因素共同推动了玻璃在封装技术中的应用。
目前,众多领先的设备制造商和材料供应商都在积极研究玻璃封装技术。英特尔在其亚利桑那生产线上演示了基于玻璃的测试平台,三星电子正在探索将玻璃芯作为其封装技术的潜在选择,基板巨头SKC和玻璃巨头AGC也在积极布局玻璃封装技术的研发和生产。
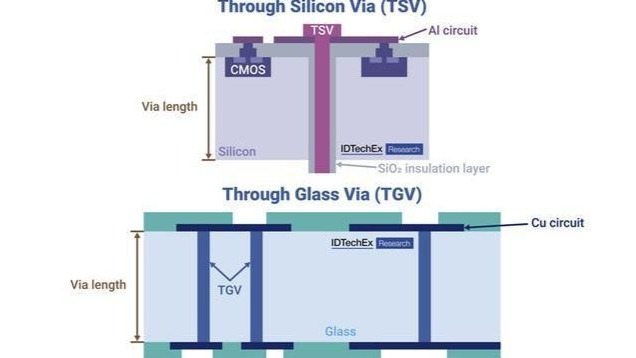
除了计算封装领域,玻璃在高频和光子集成方面也有着广阔的应用前景。其低介电损耗和光学透明性使其成为高频信号传输和光子器件的理想材料。在Ka波段及以上频段,玻璃微带的插入损耗远低于等效有机线,这使得玻璃在高频通信领域具有独特的优势。
共封装光学器件(CPO)技术的发展也为玻璃提供了新的应用机会。通过将光纤连接移至距离交换机ASIC仅几毫米的基板上,CPO技术可以大大简化对准过程并降低成本。而玻璃作为基板材料,可以承载电气重分布层和低损耗波导,从而进一步推动CPO技术的发展。
然而,玻璃封装技术的量产并非易事。除了原材料供应外,还需要建立完善的激光钻孔、铜填充、面板处理和设计自动化生态系统。良率、通孔填充可靠性、面板翘曲和设计套件成熟度等因素都将影响玻璃封装技术的成本和应用前景。因此,了解相关技术的最新进展和竞争格局,对于把握玻璃封装技术的发展机遇至关重要。
同时,玻璃也面临着来自硅和改进的有机材料的竞争。代工厂正在推动混合晶圆级重新分配技术的发展,以缩小玻璃在特征尺寸方面的优势。而层压板供应商也在积极开发具有更低粗糙度和更佳热膨胀系数匹配的下一代材料。这些竞争态势将进一步推动半导体封装技术的创新和发展。




















